盛夏時節(jié),半導體行業(yè)再次迎來萬眾矚目的SEMICON China展會,作為全球最大規(guī)模、最具影響力的行業(yè)盛事,該展會匯聚了半導體產業(yè)的頂尖企業(yè)和專業(yè)人士,共同探討行業(yè)前沿技術及未來發(fā)展趨勢。
作為半導體封裝設備領域的創(chuàng)新者,邁為股份已通過持續(xù)不斷的研發(fā)攻關,突破多項關鍵核心技術,率先實現了半導體晶圓激光開槽、激光改質切割、刀輪切割、研磨等多款裝備的國產化。
本次展會,公司發(fā)布并展示了其自主研發(fā)的先進技術成果——碳化硅研磨設備、 Wafer Handling激光改質切割設備以及刀輪切割設備,吸引了無數行業(yè)伙伴前來參觀交流、洽談合作,現場觀眾絡繹不絕。

這幾款產品有何技術優(yōu)勢和獨到之處呢?以下為您一一呈現!

碳化硅研磨設備
該設備應用于4/6/8英寸碳化硅、藍寶石等硬質材料晶圓的減薄
可視化操作管理,實時顯示和監(jiān)控關鍵加工信息
視覺檢測和定位系統可識別晶圓正反面,實現自動定位補償
物料信息掃描錄入、防止晶圓斜插
Fab晶圓級搬運手臂
雙高剛性氣浮主軸設計,搭配自主研制的高目數磨輪

半導體晶圓激光改質切割設備
該設備應用于8/12英寸硅晶圓及碳化硅、氮化鎵等第三代半導體內部改質切割
配備高功率紅外激光器(極小的激光濺射),可兼容不同厚度的晶圓產品切割需求
高精密直線電機,高速度X-Y運動平臺
配備SLM激光調制技術,具有光斑整型及補償功能
配備DFT動態(tài)追蹤補償系統,具有高精度的晶圓表面起伏追蹤及補償系統
配備雙光束(2-Beam)同時加工作業(yè)

半導體晶圓刀輪切割設備
該設備應用于8/12英寸半導體晶圓領域的全自動劃切加工
配置上料區(qū)FFU、料層MAPPING和凸料檢測等功能
高性能位置測量和運動控制,實現更小的熱誤差和更高的設備精度
自研破刀檢測(BBD)系統和非接觸式測高(NCS)系統
切痕檢測,自動糾偏
全尺寸在線磨刀功能
水氣二流體清洗,標配水流量監(jiān)控、氣壓監(jiān)控
封裝設備是半導體產業(yè)鏈的重要環(huán)節(jié),對于芯片產品的關鍵性能、可靠性、產能都有著很大影響,裝備須要有極高的精度與極強的穩(wěn)定性,因此研制難度較大,即使研制成功,也難以通過客戶端的嚴苛驗證要求。
而依托先進的科研平臺,邁為股份以極高的研發(fā)效率就多款封裝設備實現了從樣品研制、順利驗證、客戶認可、正式訂單的快速突破,其中,半導體晶圓研磨設備、激光開槽設備、Frame Handling激光改質切割設備、刀輪切割設備等已交付客戶并實現穩(wěn)定量產,以領先的產品優(yōu)勢贏得了諸多客戶的認可與信賴。
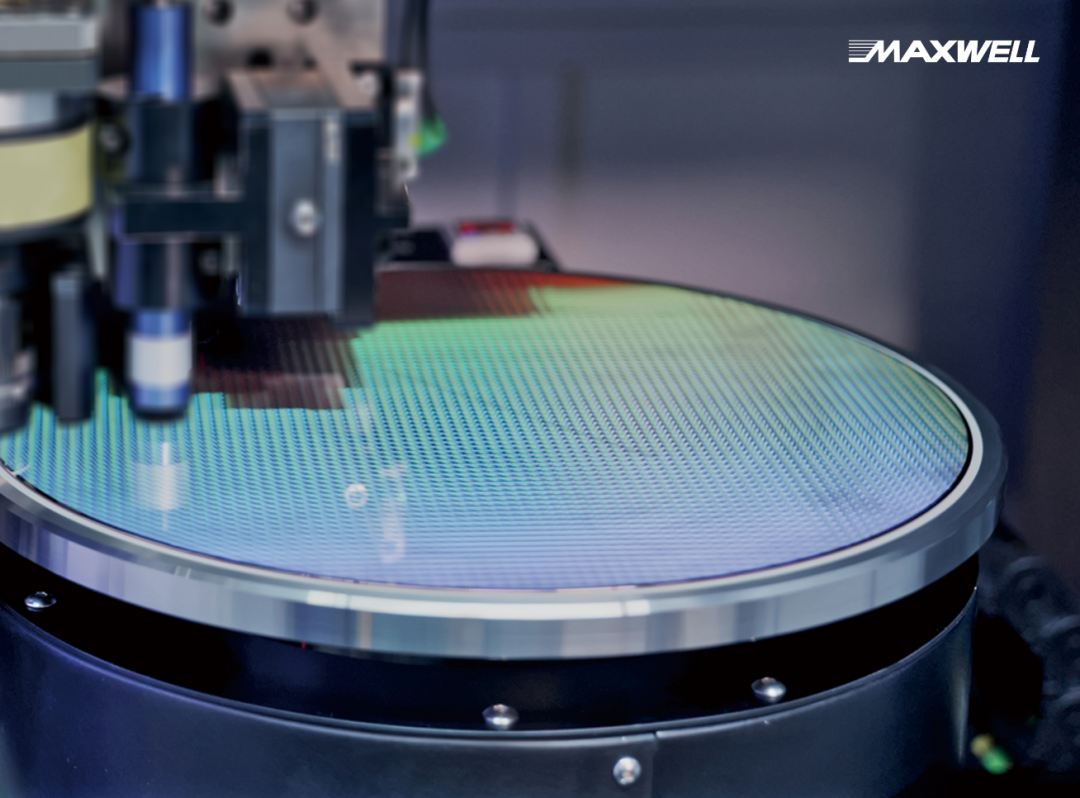
未來,邁為股份仍將致力創(chuàng)新、以激光、超高速高精密等技術為基礎,聚焦半導體泛切割、2.5D/3D先進封裝, 不斷優(yōu)化、拓展裝備產品陣容,提供封裝工藝整體解決方案,助推半導體產品工藝的不斷升級, 為行業(yè)發(fā)展貢獻力量。


